Institute of Physics of Materials AS CR, v. v. i. > Groups > Electron Microscopy and advanced analysis of materials

 Talos™ F200i transmission electron microscope
Talos™ F200i transmission electron microscope
Contact person: Ing. Ivo Kuběna, Ph.D.
The Thermo Scientific™ Talos F200i TEM is a 20-200 kV transmission electron microscope with a field electron gun (FEG).
 JEOL JEM-2100F transmission electron microscope
JEOL JEM-2100F transmission electron microscope
Contact person: Ing. Ivo Kuběna, Ph.D.
JEOL JEM-2100F TEM is a multipurpose analytical electron microscope with field electron gun (FEG).
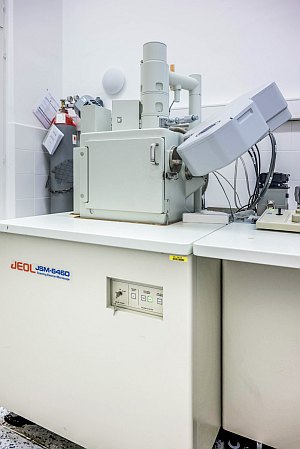 JEOL JSM-6460 scanning electron microscope
JEOL JSM-6460 scanning electron microscope
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
JEOL JSM-6460 scanning electron microscope with tungsten electron source.
 MightyEBIC 2.0 (Ephemeron Labs)
MightyEBIC 2.0 (Ephemeron Labs)
Contact person: doc. Ing. Roman Gröger, Ph.D.
Scan controller and data acquisition interface for making quantitative Electron Beam Induced Current (EBIC) measurements.
 Sputter coater Quorum 150T
Sputter coater Quorum 150T
Contact person: Ing. Peter Smatana
The Q150T system is a versatile turbo sputter for preparing samples for observation in a scanning electron microscope.
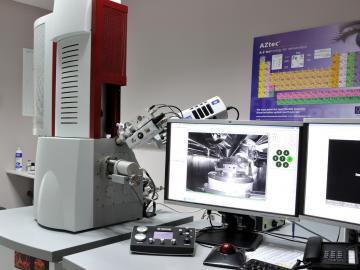 Scanning electron microscope Tescan LYRA 3 XMH FEG/SEMxFIB
Scanning electron microscope Tescan LYRA 3 XMH FEG/SEMxFIB
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Tescan LYRA 3 XMH FEG/SEM scanning electron microscope with a FEG electron source.
 Scanning electron microscope Tescan LYRA 3 XMU FEG/SEMxFIB
Scanning electron microscope Tescan LYRA 3 XMU FEG/SEMxFIB
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Scanning electron microscope Tescan LYRA 3 XMU FEG/SEMxFIB with FEG electron source.
 SPM LiteScope (NenoVision)
SPM LiteScope (NenoVision)
Contact person: doc. Ing. Roman Gröger, Ph.D.
Scanning Probe Microscope (SPM) designed for easy integration into the Scanning Electron Microscopes. The combination of complementary AFM and SEM techniques enables to use the advantages of both commonly used microscopy techniques. LiteScope incorporates a unique imaging technique "Correlative Probe and Electron Microscopy (CPEM)" enabling simultaneous acquisition of AFM and SEM data. LiteScope and the CPEM technology allow sample analysis in a way that was previously difficult or impossible by the two imaging technologies simultaneously.
 TenuPol 5
TenuPol 5
Contact person: Ing. Peter Smatana
TenuPol-5 is a device designed for automated electropolishing and etching of metallographic samples for observation in a transmission electron microscope.
 OPAL 410 Hot Mounting Press ATM
OPAL 410 Hot Mounting Press ATM
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Fully automatic Opal 410 hot mounting metallographic press with an electro-hydraulic system and an included cooling system for automatic specimen cooling is used for the preparation of metallographic specimens.
 Brillant 220 automatic / manual metallographic saw Metalco
Brillant 220 automatic / manual metallographic saw Metalco
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Brillant-220 is an universal precision saw designed for manual and automatic precision cutting of very small and larger specimens.
 Digital microscope Olympus DSX1000
Digital microscope Olympus DSX1000
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
The Olympus DSX1000 digital microscope enables recording of 2D / 3D images using long working distance objective lenses.
 GW INSTEK PSU 60-25 programmable laboratory power supply
GW INSTEK PSU 60-25 programmable laboratory power supply
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
GW INSTEK PSU 60-25 DC switching laboratory power supply is a programmable power supply with an output voltage of 0-60 V and a maximum output current of 25 A.
 Mortar grinder Fritsch Pulverisette 2
Mortar grinder Fritsch Pulverisette 2
Contact person: Ing. Hynek Hadraba, Ph.D.
Mechanical mortar for milling and mixing powders.
 UF55 universal oven Memmert
UF55 universal oven Memmert
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Universal equipment suitable for drying, heating, aging, burn-in, and hardening.
 Olympus GX51 Inverted Metallographic Microscope
Olympus GX51 Inverted Metallographic Microscope
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
The GX51 inverted microscope provides high stability to support excellent image clarity and superb resolution with high magnifications and comfortable operability.
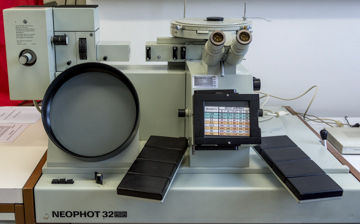 ZEISS Neophot 32 Metallographic Microscope
ZEISS Neophot 32 Metallographic Microscope
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
The inverted optical metallographic microscope for structural analysis of examined samples in a bright/dark field, polarized light, and differential interferometric contrast.
 Duramin microhardness tester Struers
Duramin microhardness tester Struers
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Duramin microhardness tester for Vickers and Knoop hardness tests performed in a range of loads from 98.07 mN (10 g) to 19.61 N (2 kg).
 P750 DOSTMANN thermometer with immersion probe
P750 DOSTMANN thermometer with immersion probe
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
P750 DOSTMANN thermometer with an immersion probe allows temperature measurement of liquids and loose materials in measuring range from -100 to 1100 ° C with the possibility of on-line data processing.
 SD1600 digital hotplate Stuart
SD1600 digital hotplate Stuart
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Digital hotplate with microprocessor temperature control and LCD display.
 Precision Ion Polishing System (PIPS) Gatan MODEL 691
Precision Ion Polishing System (PIPS) Gatan MODEL 691
Contact person: Ing. Dagmar Herzánová
The System for TEM samples preparation by argon ions polishing
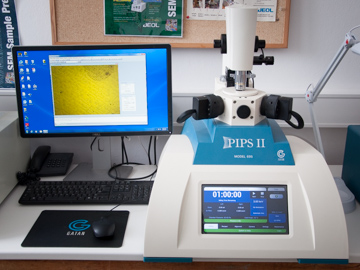 Precision Ion Polishing System (PIPS II), Gatan MODEL 695
Precision Ion Polishing System (PIPS II), Gatan MODEL 695
Contact person: Ing. Dagmar Herzánová
The instrument designed to produce high-quality TEM specimens by argon ions polishing.
 Cross Section Polisher SM-09010, JEOL
Cross Section Polisher SM-09010, JEOL
Contact person: Ing. Dagmar Herzánová
Preparation of cross sections of different materials using an argon ion beam for SEM investigation.
 Saphir 320 and 330 Grinding & Polishing Machines ATM
Saphir 320 and 330 Grinding & Polishing Machines ATM
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Single/double wheel manual grinders and polishers with Ø 230 mm wheels are used for specimens grinding on grinding papers/discs and polishing on polishing clothes with diamond pastes or suspensions.
 Jacomex GP Campus glovebox
Jacomex GP Campus glovebox
Contact person: Ing. Hynek Hadraba, Ph.D.
The stainless steel glovebox with glass protective shield allows work in an atmosphere of inert gases (Ar, He).
 Saphir 550 automatic grinder and polisher with Rubin 520 grinding unit Metalco
Saphir 550 automatic grinder and polisher with Rubin 520 grinding unit Metalco
Contact person:
Saphir 550 automatic single-disc preparation system with 300 mm disk is designed for grinding and polishing of metallographic specimens.
 Jenway 7415 spectrophotometer
Jenway 7415 spectrophotometer
Contact person: doc. Ing. Roman Gröger, Ph.D.
Jenway 7415 spectrophotometer allows measurement of spectra in ultraviolet and visible spectrum and the concentration of solutions.
 Stereomicroscope Leica S9i
Stereomicroscope Leica S9i
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Compact stereomicroscope with an optical system with 12° scattering optical paths and and apochromatic optics incorporated in the microscope and an integrated camera.
 Tergeo plasma cleaner
Tergeo plasma cleaner
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Compact cleaner designed for SEM specimen cleaning, activating functional groups on polymers, metals, and ceramics, achieving hydrophilic wettability, improving bonding strength and printability, etc.
 Thermostat Lauda RP 290 E
Thermostat Lauda RP 290 E
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Lauda RP 290 E circulation thermostat is designed for external applications where rapid temperature changes are required (e.g. electrolyte cooling).
 DuraScan 70 G5 ZwickRoell hardness tester
DuraScan 70 G5 ZwickRoell hardness tester
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
The DuraScan 70 G5 hardness tester enables measurements using the Vickers method in the load range from 0.01 to 60 kg.
 ZHV30 Vickers Hardness Tester ZwickRoell
ZHV30 Vickers Hardness Tester ZwickRoell
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
The ZHV30 low-load Vickers hardness tester used for hardness tests according to ISO 6507 and ASTM E384 in the test-load range from HV0.2 to HV30.
 Sonopuls ultrasonic homogenizer Bandelin
Sonopuls ultrasonic homogenizer Bandelin
Contact person: Ing. Luca Bertolla, Ph.D.
Sonopuls ultrasonic homogenizer generates high-performance ultrasound with high intensities and ultrasonic amplitudes, which are transferred into liquid media using the probe (metal tip).
 Rockwell 150CLK ZwickRoell universal hardness tester
Rockwell 150CLK ZwickRoell universal hardness tester
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
The Rockwell 150CLK universal hardness tester enables hardness measurements in the range of 5 to 187.5 kg.
 Quintix® 224-1S precision balance Sartorius
Quintix® 224-1S precision balance Sartorius
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Accurate 0.1 mg precision balance with weighing capacity of 220 g and with internal, fully automatic, temperature and time-controlled "isoCAL" calibration, or manual external calibration.
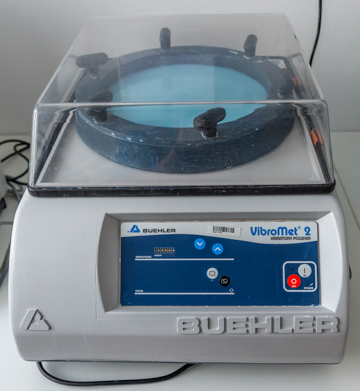 VibroMet 2 Vibratory Polisher Buehler
VibroMet 2 Vibratory Polisher Buehler
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
VibroMet 2 Vibratory Polisher is designed to prepare high quality polished surfaces on a wide variety of problematically polished materials (such as soft materials, superalloys, microelectronic parts, etc.).
 LectroPol-5 electrolytic polishing machine
LectroPol-5 electrolytic polishing machine
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
LectroPol-5 is designed for automatized electrolytic polishing and etching of metallographic specimens.
 Panalytical ZetaSizer Ultra Malvern
Panalytical ZetaSizer Ultra Malvern
Contact person: doc. Ing. Roman Gröger, Ph.D.
The Zetasizer Ultra is a system for the measurement of particle and molecular size in the range from 0.3 nm to 10 µm, particle charge and particle concentration.
 3D printer Prusa SL1
3D printer Prusa SL1
Contact person: Bc. Adam Weiser
This 3D printer is based on SLA technology. It means a resin is cured with UV light layer by layer. In our laboratory we often use that for making sample holders useful for grinding or electrochemical experiments..
 VC-50 saw LECO
VC-50 saw LECO
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Precision saw with the diamond cutting disc is suitable for cutting extremely hard materials.
 MATRIX MPS-7061 60V/10A power supply
MATRIX MPS-7061 60V/10A power supply
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
DC regulated power supply of constant voltage or current is used for electrolytic polishing and etching.
Nic nebylo nalezeno / nothing found
SELECT p.* FROM papers as p, xauthors as x, xgroups as xg WHERE xg.id_author=x.id_author AND p.id=x.id_paper and xg.id_group=10 GROUP BY id, title ORDER BY p.year DESC limit 0,100

Electron Microscopy and advanced analysis of materials
| Head | doc. Ing. Stanislava Fintová, Ph.D. |
| [javascript protected email address] | |
| Phone number | +420 532 290 301 |
| Room | 317 |
The EM group takes care of the operation and maintenance of electron microscopes, the development of microscopic techniques and their successful applications for solving the research tasks. The group covers top quality transmission electron microscopy (TEM) specimen preparation by various techniques.
Secondary and backscattered electrons are used for basic imagining in scanning electron microscopes (SEM). Moreover, SEMs are equipped with various detectors. EDS or WDS detectors are used for chemical analysis and EBSD detector plays a key role in phase or texture analysis. Two focused ion columns (FIB) together with a gas injection system offer other possibilities. Ga ions can be used for imagining and deposition of thin layers or micromachining on the microscale. The FIB technique is, for example, frequently used for site-specific TEM specimen preparation.
Two TEMs with the atomic resolution are present at IPM. TEMs might be operated in standard TEM mode as well as in scanning mode (STEM). STEM using bright field and high angle angular dark field detector is an unreplaceable method in microstructural analysis. Both TEMs are equipped with EDS detectors for chemical analysis on a nanometric level. One TEM is equipped with a Lorentz lens and biprism for holography.
Members of the group are capable of specimen preparation and microstructure documentation and data processing and analysis via appropriate software. The members keep cooperating with companies producing microscopes on the development of advanced microscopic techniques and their modification for specific needs of the research taking place at IPM. The group belongs to an infrastructural part of the department of Experimental Studies and Modelling of Structure.
The laboratory focuses on the preparation of nano to macro particle precursors for newly developing materials. Apart from the preparation of new materials, the Laboratory offers an analysis of a wide range of materials via light optical microscopy and selective/color etching. Another field of expertise is the preparation of a top quality surface for EBSD and AFM analysis, defect-free complex surfaces preparation via electrolytic and chemical polishing and hardness measurement.
Secondary and backscattered electrons are used for basic imagining in scanning electron microscopes (SEM). Moreover, SEMs are equipped with various detectors. EDS or WDS detectors are used for chemical analysis and EBSD detector plays a key role in phase or texture analysis. Two focused ion columns (FIB) together with a gas injection system offer other possibilities. Ga ions can be used for imagining and deposition of thin layers or micromachining on the microscale. The FIB technique is, for example, frequently used for site-specific TEM specimen preparation.
Two TEMs with the atomic resolution are present at IPM. TEMs might be operated in standard TEM mode as well as in scanning mode (STEM). STEM using bright field and high angle angular dark field detector is an unreplaceable method in microstructural analysis. Both TEMs are equipped with EDS detectors for chemical analysis on a nanometric level. One TEM is equipped with a Lorentz lens and biprism for holography.
Members of the group are capable of specimen preparation and microstructure documentation and data processing and analysis via appropriate software. The members keep cooperating with companies producing microscopes on the development of advanced microscopic techniques and their modification for specific needs of the research taking place at IPM. The group belongs to an infrastructural part of the department of Experimental Studies and Modelling of Structure.
The laboratory focuses on the preparation of nano to macro particle precursors for newly developing materials. Apart from the preparation of new materials, the Laboratory offers an analysis of a wide range of materials via light optical microscopy and selective/color etching. Another field of expertise is the preparation of a top quality surface for EBSD and AFM analysis, defect-free complex surfaces preparation via electrolytic and chemical polishing and hardness measurement.
Technicians
| Name | Phone numbers | Rooms | |
|---|---|---|---|
| Ing. Denisa Beranová | +420 532 290 383 | 209 | [javascript protected email address] |
| Ing. Dagmar Herzánová | +420 532 290 482 | 318 | [javascript protected email address] |
| Ing. Vít Horník, Ph.D. | +420 532 290 418 | 325 | [javascript protected email address] |
| Ing. Zdeněk Jakůbek | +420 532 290 384 | 207 | [javascript protected email address] |
| Ing. Ivana Podstranská | +420 532 290 481 | 407 | [javascript protected email address] |
| Ing. Peter Smatana | +420 532 290 432 | 323 | [javascript protected email address] |
| Project number | Name | Investigator |
|---|---|---|
| 13-28685P | Identification of fatigue damage mechanisms in modern steels under development for fusion and nuclear reactors | Ing. Ivo Kuběna, Ph.D. |
 Talos™ F200i transmission electron microscope
Talos™ F200i transmission electron microscopeContact person: Ing. Ivo Kuběna, Ph.D.
The Thermo Scientific™ Talos F200i TEM is a 20-200 kV transmission electron microscope with a field electron gun (FEG).
 JEOL JEM-2100F transmission electron microscope
JEOL JEM-2100F transmission electron microscopeContact person: Ing. Ivo Kuběna, Ph.D.
JEOL JEM-2100F TEM is a multipurpose analytical electron microscope with field electron gun (FEG).
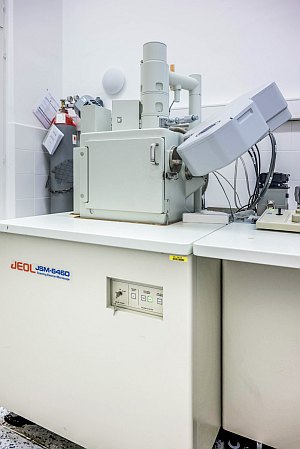 JEOL JSM-6460 scanning electron microscope
JEOL JSM-6460 scanning electron microscopeContact person: doc. Ing. Stanislava Fintová, Ph.D.
JEOL JSM-6460 scanning electron microscope with tungsten electron source.
 MightyEBIC 2.0 (Ephemeron Labs)
MightyEBIC 2.0 (Ephemeron Labs)Contact person: doc. Ing. Roman Gröger, Ph.D.
Scan controller and data acquisition interface for making quantitative Electron Beam Induced Current (EBIC) measurements.
 Sputter coater Quorum 150T
Sputter coater Quorum 150TContact person: Ing. Peter Smatana
The Q150T system is a versatile turbo sputter for preparing samples for observation in a scanning electron microscope.
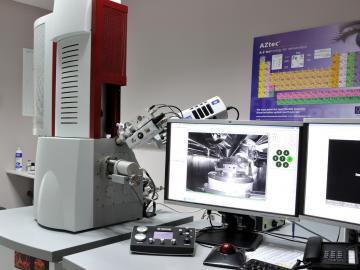 Scanning electron microscope Tescan LYRA 3 XMH FEG/SEMxFIB
Scanning electron microscope Tescan LYRA 3 XMH FEG/SEMxFIBContact person: doc. Ing. Stanislava Fintová, Ph.D.
Tescan LYRA 3 XMH FEG/SEM scanning electron microscope with a FEG electron source.
 Scanning electron microscope Tescan LYRA 3 XMU FEG/SEMxFIB
Scanning electron microscope Tescan LYRA 3 XMU FEG/SEMxFIBContact person: doc. Ing. Stanislava Fintová, Ph.D.
Scanning electron microscope Tescan LYRA 3 XMU FEG/SEMxFIB with FEG electron source.
 SPM LiteScope (NenoVision)
SPM LiteScope (NenoVision)Contact person: doc. Ing. Roman Gröger, Ph.D.
Scanning Probe Microscope (SPM) designed for easy integration into the Scanning Electron Microscopes. The combination of complementary AFM and SEM techniques enables to use the advantages of both commonly used microscopy techniques. LiteScope incorporates a unique imaging technique "Correlative Probe and Electron Microscopy (CPEM)" enabling simultaneous acquisition of AFM and SEM data. LiteScope and the CPEM technology allow sample analysis in a way that was previously difficult or impossible by the two imaging technologies simultaneously.
 TenuPol 5
TenuPol 5Contact person: Ing. Peter Smatana
TenuPol-5 is a device designed for automated electropolishing and etching of metallographic samples for observation in a transmission electron microscope.
 OPAL 410 Hot Mounting Press ATM
OPAL 410 Hot Mounting Press ATMContact person: doc. Ing. Stanislava Fintová, Ph.D.
Fully automatic Opal 410 hot mounting metallographic press with an electro-hydraulic system and an included cooling system for automatic specimen cooling is used for the preparation of metallographic specimens.
 Brillant 220 automatic / manual metallographic saw Metalco
Brillant 220 automatic / manual metallographic saw MetalcoContact person: doc. Ing. Stanislava Fintová, Ph.D.
Brillant-220 is an universal precision saw designed for manual and automatic precision cutting of very small and larger specimens.
 Digital microscope Olympus DSX1000
Digital microscope Olympus DSX1000Contact person: doc. Ing. Stanislava Fintová, Ph.D.
The Olympus DSX1000 digital microscope enables recording of 2D / 3D images using long working distance objective lenses.
 GW INSTEK PSU 60-25 programmable laboratory power supply
GW INSTEK PSU 60-25 programmable laboratory power supplyContact person: doc. Ing. Stanislava Fintová, Ph.D.
GW INSTEK PSU 60-25 DC switching laboratory power supply is a programmable power supply with an output voltage of 0-60 V and a maximum output current of 25 A.
 Mortar grinder Fritsch Pulverisette 2
Mortar grinder Fritsch Pulverisette 2Contact person: Ing. Hynek Hadraba, Ph.D.
Mechanical mortar for milling and mixing powders.
 UF55 universal oven Memmert
UF55 universal oven MemmertContact person: doc. Ing. Stanislava Fintová, Ph.D.
Universal equipment suitable for drying, heating, aging, burn-in, and hardening.
 Olympus GX51 Inverted Metallographic Microscope
Olympus GX51 Inverted Metallographic MicroscopeContact person: doc. Ing. Stanislava Fintová, Ph.D.
The GX51 inverted microscope provides high stability to support excellent image clarity and superb resolution with high magnifications and comfortable operability.
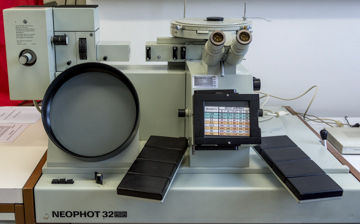 ZEISS Neophot 32 Metallographic Microscope
ZEISS Neophot 32 Metallographic MicroscopeContact person: doc. Ing. Stanislava Fintová, Ph.D.
The inverted optical metallographic microscope for structural analysis of examined samples in a bright/dark field, polarized light, and differential interferometric contrast.
 Duramin microhardness tester Struers
Duramin microhardness tester StruersContact person: doc. Ing. Stanislava Fintová, Ph.D.
Duramin microhardness tester for Vickers and Knoop hardness tests performed in a range of loads from 98.07 mN (10 g) to 19.61 N (2 kg).
 P750 DOSTMANN thermometer with immersion probe
P750 DOSTMANN thermometer with immersion probeContact person: doc. Ing. Stanislava Fintová, Ph.D.
P750 DOSTMANN thermometer with an immersion probe allows temperature measurement of liquids and loose materials in measuring range from -100 to 1100 ° C with the possibility of on-line data processing.
 SD1600 digital hotplate Stuart
SD1600 digital hotplate StuartContact person: doc. Ing. Stanislava Fintová, Ph.D.
Digital hotplate with microprocessor temperature control and LCD display.
 Precision Ion Polishing System (PIPS) Gatan MODEL 691
Precision Ion Polishing System (PIPS) Gatan MODEL 691Contact person: Ing. Dagmar Herzánová
The System for TEM samples preparation by argon ions polishing
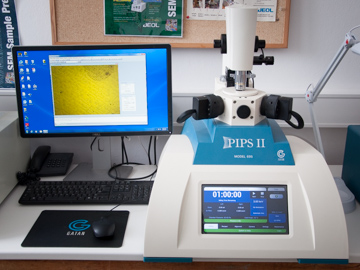 Precision Ion Polishing System (PIPS II), Gatan MODEL 695
Precision Ion Polishing System (PIPS II), Gatan MODEL 695Contact person: Ing. Dagmar Herzánová
The instrument designed to produce high-quality TEM specimens by argon ions polishing.
 Cross Section Polisher SM-09010, JEOL
Cross Section Polisher SM-09010, JEOLContact person: Ing. Dagmar Herzánová
Preparation of cross sections of different materials using an argon ion beam for SEM investigation.
 Saphir 320 and 330 Grinding & Polishing Machines ATM
Saphir 320 and 330 Grinding & Polishing Machines ATMContact person: doc. Ing. Stanislava Fintová, Ph.D.
Single/double wheel manual grinders and polishers with Ø 230 mm wheels are used for specimens grinding on grinding papers/discs and polishing on polishing clothes with diamond pastes or suspensions.
 Jacomex GP Campus glovebox
Jacomex GP Campus gloveboxContact person: Ing. Hynek Hadraba, Ph.D.
The stainless steel glovebox with glass protective shield allows work in an atmosphere of inert gases (Ar, He).
 Saphir 550 automatic grinder and polisher with Rubin 520 grinding unit Metalco
Saphir 550 automatic grinder and polisher with Rubin 520 grinding unit MetalcoContact person:
Saphir 550 automatic single-disc preparation system with 300 mm disk is designed for grinding and polishing of metallographic specimens.
 Jenway 7415 spectrophotometer
Jenway 7415 spectrophotometerContact person: doc. Ing. Roman Gröger, Ph.D.
Jenway 7415 spectrophotometer allows measurement of spectra in ultraviolet and visible spectrum and the concentration of solutions.
Carl Zeiss Jena Stereo Microscope
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Binocular stereoscopic microscope predetermined for observation of three-dimensional objects in reflected light.
Contact person: doc. Ing. Stanislava Fintová, Ph.D.
Binocular stereoscopic microscope predetermined for observation of three-dimensional objects in reflected light.
 Stereomicroscope Leica S9i
Stereomicroscope Leica S9iContact person: doc. Ing. Stanislava Fintová, Ph.D.
Compact stereomicroscope with an optical system with 12° scattering optical paths and and apochromatic optics incorporated in the microscope and an integrated camera.
 Tergeo plasma cleaner
Tergeo plasma cleanerContact person: doc. Ing. Stanislava Fintová, Ph.D.
Compact cleaner designed for SEM specimen cleaning, activating functional groups on polymers, metals, and ceramics, achieving hydrophilic wettability, improving bonding strength and printability, etc.
 Thermostat Lauda RP 290 E
Thermostat Lauda RP 290 EContact person: doc. Ing. Stanislava Fintová, Ph.D.
Lauda RP 290 E circulation thermostat is designed for external applications where rapid temperature changes are required (e.g. electrolyte cooling).
 DuraScan 70 G5 ZwickRoell hardness tester
DuraScan 70 G5 ZwickRoell hardness testerContact person: doc. Ing. Stanislava Fintová, Ph.D.
The DuraScan 70 G5 hardness tester enables measurements using the Vickers method in the load range from 0.01 to 60 kg.
 ZHV30 Vickers Hardness Tester ZwickRoell
ZHV30 Vickers Hardness Tester ZwickRoellContact person: doc. Ing. Stanislava Fintová, Ph.D.
The ZHV30 low-load Vickers hardness tester used for hardness tests according to ISO 6507 and ASTM E384 in the test-load range from HV0.2 to HV30.
 Sonopuls ultrasonic homogenizer Bandelin
Sonopuls ultrasonic homogenizer BandelinContact person: Ing. Luca Bertolla, Ph.D.
Sonopuls ultrasonic homogenizer generates high-performance ultrasound with high intensities and ultrasonic amplitudes, which are transferred into liquid media using the probe (metal tip).
 Rockwell 150CLK ZwickRoell universal hardness tester
Rockwell 150CLK ZwickRoell universal hardness testerContact person: doc. Ing. Stanislava Fintová, Ph.D.
The Rockwell 150CLK universal hardness tester enables hardness measurements in the range of 5 to 187.5 kg.
 Quintix® 224-1S precision balance Sartorius
Quintix® 224-1S precision balance SartoriusContact person: doc. Ing. Stanislava Fintová, Ph.D.
Accurate 0.1 mg precision balance with weighing capacity of 220 g and with internal, fully automatic, temperature and time-controlled "isoCAL" calibration, or manual external calibration.
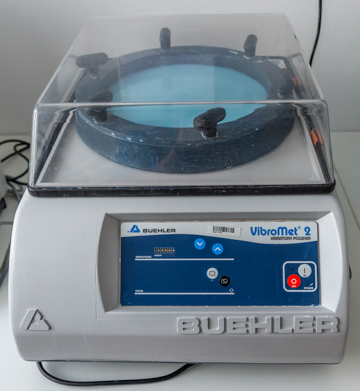 VibroMet 2 Vibratory Polisher Buehler
VibroMet 2 Vibratory Polisher BuehlerContact person: doc. Ing. Stanislava Fintová, Ph.D.
VibroMet 2 Vibratory Polisher is designed to prepare high quality polished surfaces on a wide variety of problematically polished materials (such as soft materials, superalloys, microelectronic parts, etc.).
 LectroPol-5 electrolytic polishing machine
LectroPol-5 electrolytic polishing machineContact person: doc. Ing. Stanislava Fintová, Ph.D.
LectroPol-5 is designed for automatized electrolytic polishing and etching of metallographic specimens.
 Panalytical ZetaSizer Ultra Malvern
Panalytical ZetaSizer Ultra MalvernContact person: doc. Ing. Roman Gröger, Ph.D.
The Zetasizer Ultra is a system for the measurement of particle and molecular size in the range from 0.3 nm to 10 µm, particle charge and particle concentration.
 3D printer Prusa SL1
3D printer Prusa SL1Contact person: Bc. Adam Weiser
This 3D printer is based on SLA technology. It means a resin is cured with UV light layer by layer. In our laboratory we often use that for making sample holders useful for grinding or electrochemical experiments..
 VC-50 saw LECO
VC-50 saw LECOContact person: doc. Ing. Stanislava Fintová, Ph.D.
Precision saw with the diamond cutting disc is suitable for cutting extremely hard materials.
 MATRIX MPS-7061 60V/10A power supply
MATRIX MPS-7061 60V/10A power supplyContact person: doc. Ing. Stanislava Fintová, Ph.D.
DC regulated power supply of constant voltage or current is used for electrolytic polishing and etching.
Nic nebylo nalezeno / nothing found
SELECT p.* FROM papers as p, xauthors as x, xgroups as xg WHERE xg.id_author=x.id_author AND p.id=x.id_paper and xg.id_group=10 GROUP BY id, title ORDER BY p.year DESC limit 0,100


